SEMICON
반도체 제조를 위한 공정 중 웨이퍼 상에 식각 및 증착 공정을 수행하는 건식(Etcher)(Deposition) 식각 장치와 그 외에 공정 장비인 진공(Dry Etcher) 증착 등의 공정에서 과도한 열이 발생한다.
따라서 Chamber 내부 및 Wafer 주변 온도를 일정하게 유지할 수 있도록 온도의 정밀제어가 요구되는데, 이 온도를 일정하게 유지함으로써 공정 효율을 개선하는 장치를 Chiller라 한다.
< 반도체 8대 공정 >

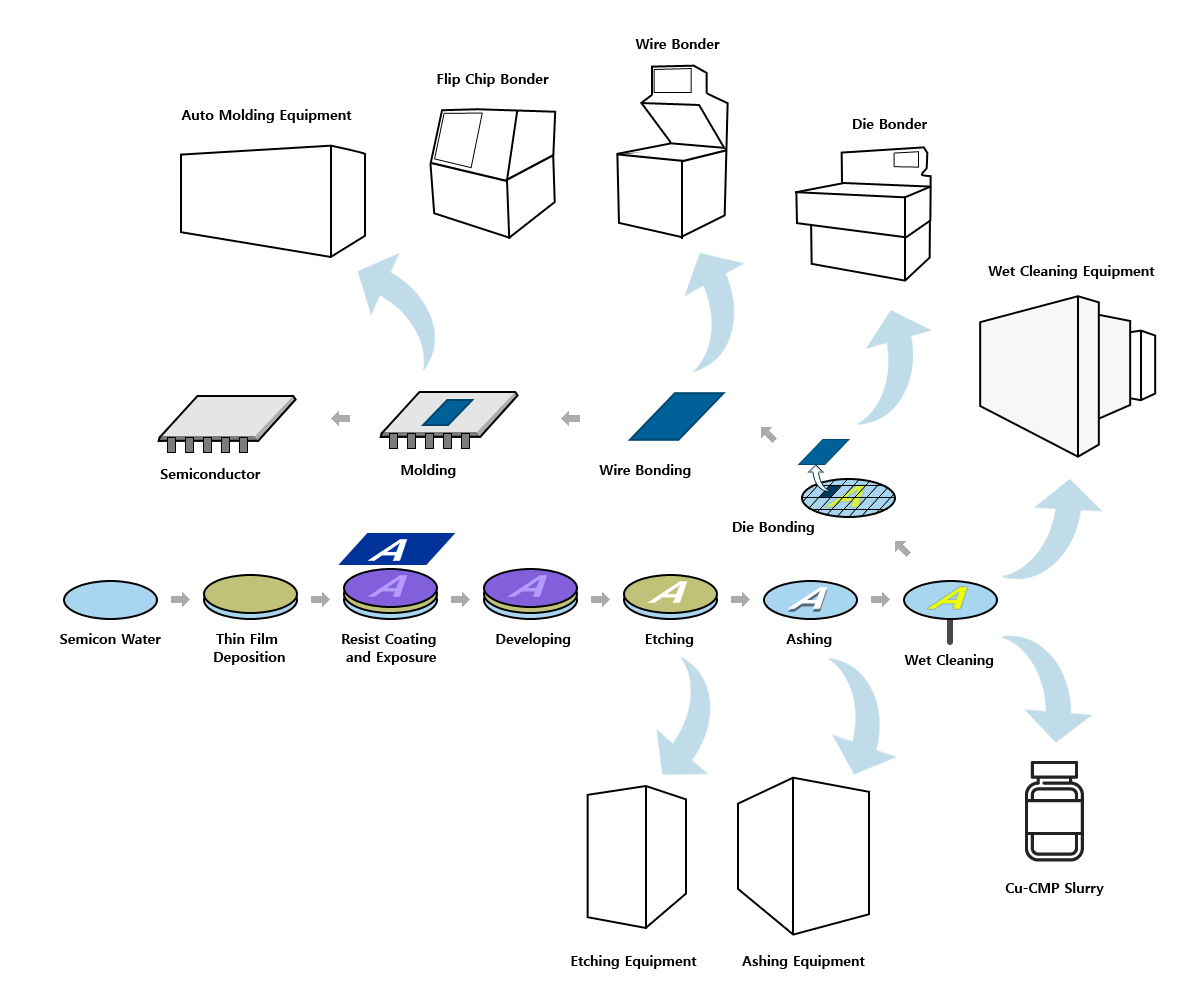
| Parallel Plate Diode Sputtering System | Ion Beam Sputtering System |
|---|---|
 |
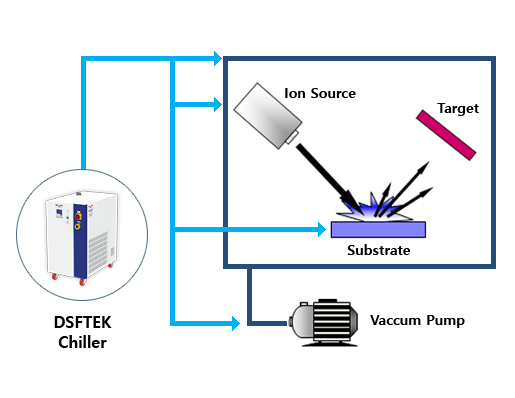 |
|
|
| Parallel Plate Diode Sputtering System |
|---|
 |
|
| Ion Beam Sputtering System |
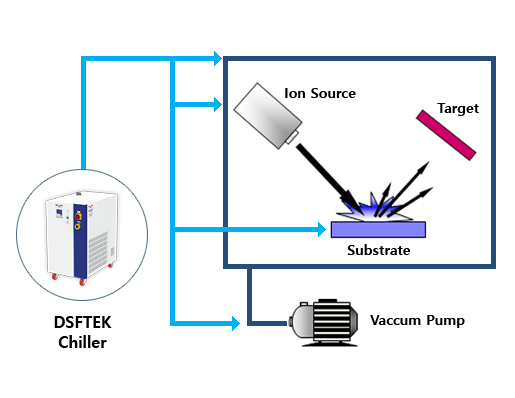 |
|
두 번째는 열적인 특성이다.
EUV가 펠리클 박막에 흡수되면 그 흡수 에너지는 대부분 열에너지로 변환돼 펠리클 박막의 온도가 급격히 올라간다. 펠리클 구조와 환경적 요인으로 인해 냉각이 쉽지 않다. 냉각의 메커니즘은 전도(Conduction), 대류(Convection), 방사(Radiation)의 세 가지 원리가 존재하는데 EUV 펠리클은 매우 얇아서 단면적이 작으므로 전도에 의한 열전달이 거의 없다.
그리고 EUV 노광장비는 고진공을 유지하므로 대류에 의한 냉각도 쉽지 않다. 그러나 마스크(펠리클) 부근에는 국부적으로 수소 라디칼의 흐름을 만들어 주고 있어, 대류에 의한 냉각 효과가 약간은 있을 수 있긴 하다.
마지막으로 방사라는 메커니즘이 EUV 펠리클의 주된 냉각효과를 가져다 줄 수 있는데, 안타깝게도 EUV 투과도가 높은 실리콘(Si) 계열의 물질들은 방사율(Emissivity)이 높지 않다. 특히 두께가 낮아짐에 따라 방사율이 급격히 감소하는 경향을 가지고 있어 상황은 더 심각하다. 따라서 노광공정 시 EUV광이 스캐닝되면 약 600-1200℃까지 순간적으로 가열되었다가 실온까지 냉각되는 열충격이 반복되게 된다.
고온에 의한 펠리클 박막의 변형 뿐만 아니라 반복되는 열충격에 의한 피로파괴가 일어난다면 펠리클로서의 성능을 잃을 뿐만 아니라, 파괴로 인한 노광기 쳄버의 오염은 노광장비 운영에 있어서 큰 재난이 아닐 수 없다.
[출처 : 전자부품 전문 미디어 디일렉(http://www.thelec.kr)]